Prezentare pe nanolithography - Dl. Stefanovic
Prezentarea pe tema: „“ nanolithography „Stefanovic GB Unul dintre procesele cheie in domeniul microelectronicii pentru mai mult de 40 de ani continuă să fie litografie“. - Transcrierea:
1 "nanolithography" Stefanovic GB

2 Unul dintre procesele definitorii în microelectronică pentru mai mult de 40 de ani continuă să fie litografie. Litografia sau microlitografia, dar acum poate fi adecvată pentru a vorbi de nanolitografie, concepute pentru a crea o figură topologică pe suprafața unei plachete de siliciu monocristalin. litografice proces de bază în domeniul microelectronicii moderne este fotolitografie.

Martie 10 etape ale procesului de litografie. 1. Pregătirea suprafeței (spălare și uscare) 2. Aplicarea (centrifugarea peliculă subțire de polimer este depus) rezista 3. uscare (îndepărtarea solventului și transferul fotorezistul solubil într-o fază solidă) foto-mască 4. Combinația și expunerea (rezista pozitiv este expus la lumină devine fază insolubilă ) 5. manifestarea rezista (spălarea într-un solvent, elimina neexpus rezista)
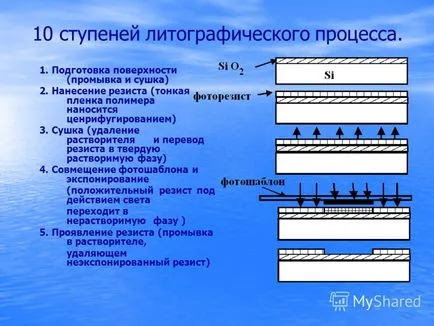
4 6. Stabilizarea recoacere (îndepărtarea solventului rezidual) 7. Controlul și corectarea defectelor. 8. Decapare (model masca directă transferată la suprafața structurii semiconductor) 9. Eliminarea controlului fotorezist Finisher.

5 Utilizarea litografiei optice pentru producerea unei structuri la scară nanometrică. Modelul de dimensiune minimă care poate fi rezolvată prin modificarea sistemului optic poate fi estimat utilizând o formulă cunoscută pentru producerea de cipuri cu 350 de modele de 360 nm nm utilizate lampă cu mercur cu arc (i linie). O creștere suplimentară a gradului de integrare a chips-uri a dus la trecerea sistemelor de litografie în zona de așa-numita ultraviolete profunda (profunda UV). 250 nm tranzistoarele desenate cu 248 nm cu laser excimer KrF cu 180 nm radiație litografie funcționează cu 198 nm cu laser excimer ArF. Viitorul litografie nm este axat pe utilizarea de 157 nm cu laser F2.

6 mască defazaj. a) șablon, fără schimbare de fază. b) model cu o schimbare de fază.

7 SURSE ALTERNATIVE DE EXPUNERE. Pentru structuri cu o rezoluție mai mică de 100 nm, devine justificată utilizarea unor metode inovatoare de expunere. Luând în considerare necesitatea de a dezvolta sisteme de litografiere de înaltă performanță sunt următoarele 4 domenii principale: limitarea sau EUV (litografie UV extreme - EUVL), proiecție de electroni litografie (bisturiul), litografia cu raze X (litografie cu raze X), litografie ion (ion beam litografie) .
8 litografia ultraviolete extreme. EUVL este litografie optic convențional, dar cu utilizarea radiației cu nm lungime de undă și optice reflectorizante, și photomasks. Surse EUVL de radiații în prima etapă de dezvoltare a unor astfel de sisteme este radiatia sincrotron. Mai târziu, cu toate acestea, a fost proiectat pentru limită compactă de putere UV, principiul de funcționare se bazează pe utilizarea de radiatii de la o plasmă cu laser. standard de Nd de emisie: YAG (1063 nm lungime de undă, de ieșire 40 W, 100 Hz frecvență, durata de 5 ns) se concentrează pe o pulsate clustere Xe cu jet de gaz.
Schema 9 EUV litografie.
Schema 10 pentru măști EUV litografie.
11 proiecție litografie cu fascicul de electroni. LIMITĂRI proiecție EBL: încălzire masca 1.Termichesky. 2. o deschidere numerică mare. Înțelegerea limitările EBL concuencnocureaacozecu a dus la apariția unor noi sisteme de proiecție EBL, dintre care unul a fost numit scalpel. Diferența principală dintre noile sisteme de cel anterior este de a utiliza un nou tip de măști. Sistemul masca bisturiul este un set de membrane realizate din elemente ușoare cu permeabilitate ridicată pentru electroni. Figura filme create din elemente grele cu grad înalt de reflexie.
12 Sistem de scalpel Principiu:
13, electronii care trec prin membrana sunt împrăștiate la unghiuri mici, în timp ce figura risipește electroni la unghiuri mari. Diafragma este situată în planul focal posterior al sistemului optic câmp trece electroni împrăștiate la unghiuri mici și trece electroni împrăștiate la unghiuri mari, ceea ce duce la formarea de imagini cu contrast ridicat pe substrat. În acest caz, o mască este nici o absorbție semnificativă a fasciculului de electroni, care minimizează instabilitatea termică a măștii.
14
15
16
OPTICS 17 SENSIBILITATE = 1060 nm 1 mJ / sm2 = 560 nm 0,5 mJ / sm2 = 118 nm 16 mJ / sm2 EL DE EXPUNERE U = 50 kV 15 C / sm2 5 U = 10 kV Cl / sm2 ENABLE mai mică de 100 nm pentru EL . U = 50 kV și doze C / sm2 KEY PARAMETRI rezista
Liniile scara submicron 18 formate pe litografie cu fascicul de electroni Si metodomi si gravare plasmochemical folosind fotorezistul oxid de vanadiu.